
2奈米良率决胜!台积电稳定领先2大对手 明年半导体市场再增18%
【记者吕承哲/台北报导】DIGITIMES 副总监蔡卓卲3日指出,2025 年科技产业正处于「又快又不稳定」的关键转折期。生成式 AI、企业 AI 与主权 AI 全面升温,带动 AI 伺服器与先进制程投资加速,其中,2奈米良率已成为全球供应链新一轮竞争的核心指标,台积电目前以60%以上的水准,明显领先三星、英特尔,呈现稳定领先态势。

【记者吕承哲/台北报导】DIGITIMES 副总监蔡卓卲3日指出,2025 年科技产业正处于「又快又不稳定」的关键转折期。生成式 AI、企业 AI 与主权 AI 全面升温,带动 AI 伺服器与先进制程投资加速,其中,2奈米良率已成为全球供应链新一轮竞争的核心指标,台积电目前以60%以上的水准,明显领先三星、英特尔,呈现稳定领先态势。

【记者吕承哲/台北报导】光焱科技(7728)20日于柜买中心举行业绩发表会,公布 2025 年第三季营收为 6373 万元,季减 19.19%、年减 39.59%,主因受到国际关税情势与科研预算递延影响。然而,公司单季毛利率依旧高达 65.6%,突显产品具高度技术含量与市场竞争力,每股盈余(EPS)为 0.65 元,前三季累计 EPS 达 1.85 元。随著矽光子(Silicon Photonics)与共同封装光学(CPO)检测新品陆续开花结果,预期明年下半年将对营收带来显著挹注。

...全反映。其中,研发支出将再创新高,聚焦3D IC、SoIC与矽光子应用,并推进面板级封装、OSAT及...
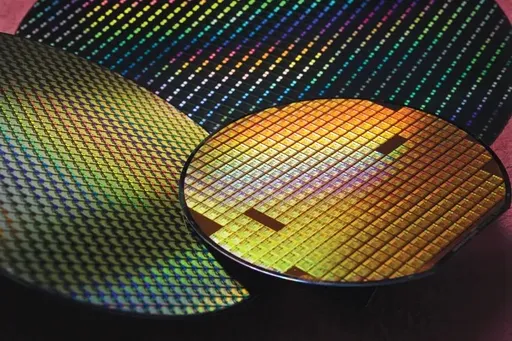
...高阶手机晶片的需求推升;先进封装技术如CoWoS与SoIC同样维持高稼动率,成为市场焦点。相较之下,...
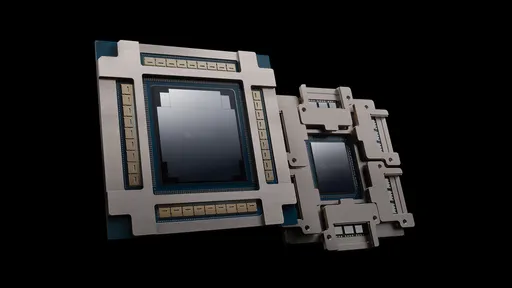
...积电 2024 年北美技术论坛,COUPE 采用 SoIC-X 晶片堆叠技术,将电子裸晶直接堆叠于光...

...弘塑强调,研发支出将再创新高,重点放在3D IC与SoIC,矽光子应用也将加速推进,并持续投资面板级...

...提升、跨学科合作与标准化等主题,并规划CoWoS、SoIC与FOPLP等关键技术路线图。随著AI、高...

...对先进封装的庞大需求。台积电3D Fabric整合SoIC、InFO与CoWoS技术,市场热议的Co...

...弘塑强调,研发支出将再创新高,重点放在3D IC与SoIC,矽光子应用也将加速推进,并持续投资面板级...

...W-X,预计面积将来到6864平方毫米,并封装4个SoIC、12个HBM4记忆体堆叠、I/O晶片与其...

...求趋于多元,除了 CoWoS,也包括 CoPoS、SoIC、WMCM 和 SoW 等技术,各项技术可...

... Pro、Max与Ultra将采用伺服器晶片等级的SoIC封装。为提升生产良率与散热效能,Apple...

...收发器,支援高速、低功耗与高可靠性数据传输。台积的SoIC技术可实现电子与光子裸晶堆叠,从电路板到中...

...Times报告指出,据传苹果的M5晶片将采用台积电SoIC封装技术,根据一份报告显示,M5处在试产阶...

【记者吕承哲/新竹报导】台积电先进技术暨光罩工程副总经理张宗生于今(15)日技术论坛表示,台积电持续领先全球半导体制造业,在先进制程、良率提升、产能扩建与全球制造平台等方面皆取得重大进展,同时为了满足AI与高效能运算(HPC)庞大需求,今年将于台湾新建9座厂房,其中台中厂年底动工,2028年导入2奈米以下先进制程。

...W-X,预计面积将来到6864平方毫米,并封装4个SoIC、12个HBM4记忆体堆叠、I/O晶片与其...

...上,台积电持续拓展CoWoS、InFO、TSMC-SoIC和矽光子等方案,满足高速、低功耗、高整合的...

...是进入CoWoS-L等版本,同时也看到客户开始导入SoIC等先进封装技术。至于面板级封装(PLP),...

...的矽光子解决方案结合了我们在尖端晶片制造和台积电 SoIC 3D 晶片堆叠技术的优势,帮助 NVID...

...考验。目前闳康可提供从2.5D CoWoS到3D SoIC等各类先进封装样品的分析服务,协助客户迅速...